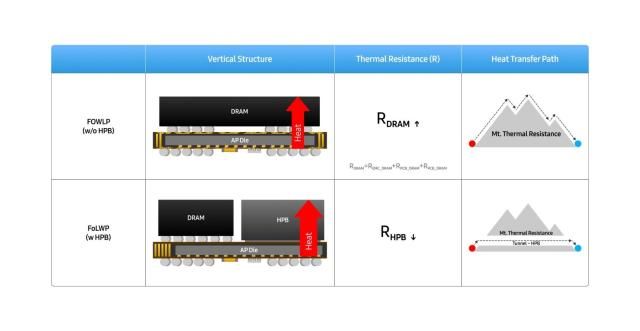
스마트폰이 얇아지고 온디바이스 인공지능(AI) 등 고성능 연산 수요가 커지면서, 모바일 애플리케이션 프로세서(AP)의 발열 관리가 성능 경쟁력의 핵심으로 떠오르고 있다. 삼성전자는 패키지 구조를 근본적으로 바꿔 열 효율을 높인 새로운 아키텍처를 선보이며 모바일 칩 설계의 한계를 돌파했다.
23일 삼성전자는 글로벌 뉴스룸을 통해 AP 상단에 '히트 패스 블록(HPB)'을 배치하는 새로운 패키지 구조를 개발해 모바일 AP의 열 방출 성능과 안정성을 동시에 개선했다고 밝혔다. 이는 팬아웃 웨이퍼 레벨 패키징(FoWLP)에 HPB를 적용한 업계 최초 사례다.
기존 플래그십 모바일 칩은 D램을 AP 위에 적층하는 'PoP(Package-on-Package)' 구조를 주로 사용해 왔다. 하지만 제품 두께 제한으로 패키지가 얇아지면서, AP에서 발생한 열이 D램을 거쳐 외부로 전달되는 경로가 길어지고 효율도 떨어지는 구조적 한계가 있었다. 솔더볼, 기판, 접착재, 몰딩 소재 등 열전도율이 낮은 재료를 통과해야 해 고부하 상황에서 발열 억제가 어려웠다.
삼성전자는 이를 해결하기 위해 D램을 발열 핵심 영역과 겹치지 않도록 재배치하고, 열원 바로 위에 HPB를 배치했다. HPB는 구리 기반 금속 구조로, 폴리머 소재 대비 열전도율이 약 500~1000배 높아 AP에서 발생한 열을 방열판이나 증기 챔버로 신속하게 전달할 수 있다. 이를 통해 패키지 내부 열 저항을 낮추고, 고부하 조건에서도 안정적인 성능을 유지할 수 있도록 했다.
이 구조는 삼성전자의 차세대 모바일 칩인 엑시노스 2600에 적용됐다. 삼성전자는 HPB 적용 과정에서 새로운 열 인터페이스 재료(TIM)를 도입해 구조적 신뢰성과 방열 성능을 동시에 확보했으며, DRAM 크기를 약 절반으로 줄이고 패키지 높이와 두께를 최적화해 전체 크기 증가도 최소화했다.
삼성전자는 "모바일 프로세서 성능이 높아질수록 패키지 수준의 열 관리 설계가 성능 지속성의 핵심 요소가 된다"며 "HPB 기반 패키지 아키텍처는 열 전달 경로를 구조적으로 개선해 얇은 폼팩터에서도 성능, 열 안정성, 공간 효율성을 동시에 달성할 수 있는 해법"이라고 설명했다.
회사는 이번 기술을 바탕으로 향후 모바일 플랫폼 전반에 패키징 혁신을 확대 적용하며, 고성능·저전력·소형화를 동시에 만족하는 차세대 AP 경쟁력을 강화해 나간다는 계획이다.
Copyright ⓒ 아주경제 무단 전재 및 재배포 금지
본 콘텐츠는 뉴스픽 파트너스에서 공유된 콘텐츠입니다.



